將光纖Bragg光柵的耦合系數k代入式(19),得最大中心反射率
Rmax=tanh2(πδnL/λB) (20)
(19)式表明反射率是常量為(|k|L)的雙曲正切函數的平方。由式(16)可知,光纖Bragg光柵可作為選頻反射器,其反射率和帶寬由δn和L決定,根據反射率R的大小有強弱光柵之分。只要光柵足夠長,總可以使反射率R=1。當不滿足相位匹配條件時,反射率會顯著變小。在光纖Bragg光柵反射濾波器中往往取正反向波傳輸常數相等,則由相位匹配條件可將式(4)寫為
光纖Bragg光柵可以將正向傳輸的模式向反向傳輸模式耦合,兩模式必須滿足相位匹配條件
βi-βr=2π/Λ (22)
將模有效折射率
則得其Bragg反射峰值波長λB與光纖Bragg光柵周期Λ的關系為
上式為Bragg反射條件。可見,改變光柵周期Λ和有效折射率neff均可以改變Bragg波長。對兩個參量之一進行調制就可制成Bragg光柵。
反射譜由兩個重要的參數決定:Bragg光柵帶寬Δλ和峰值反射率R。這些參數是光柵長度L、折射率調制深度δn和Bragg波長λB的函數。Bragg波長反射峰值帶寬(FWHM)可寫為[7]
其中,νB為Bragg頻率。N為光柵面個數(即光柵周期數),對反射率接近100%強反射光柵S≈1,而弱反射率光柵S≈1.5。由此可見,一個光纖折射率周期性變化的光柵可以反射以Bragg波長λB為中心帶寬Δλ以內的一切波長。這里引用近似帶寬[4]Δβ=4|k|,簡單的計算可得
對強光柵,即調制度δn 較大的情況下是一種較好的近似。
等間隔周期光柵具有接近于1 的峰值反射率以及極窄的反射半寬。由上式可知,R和Δλ主要決定于光柵長度L和折射率變化量δn,L受制作工藝影響一般不超過
表征光纖Bragg光柵性能的主要指標為:(1) 中心波長反射率R;(2)反射帶的半寬度;(3)光柵邊帶的抑制;(4)插入損耗。影響這些性能的因素很多,如剩余包層b越小,光柵刻的越深,則反射率越大;但隨著剩余包層的減小,光纖Bragg光柵損耗增加。隨著光柵深度增加,光纖Bragg光柵線寬加大。因此,同時得到高反射率和窄線寬的光纖Bragg光柵是很困難的,應以設法增加刻蝕光柵長度的方法來獲得高反射率的光纖Bragg光柵,并合理設計各結構參數,達到最優化設計。
3 光纖Bragg光柵制作實驗及結果
3.1 實驗裝置與方法
本文采用的相位掩模法[8,9,10]是制作光纖Bragg光柵的主要方法。根據菲涅耳近場分布計算可知,準相干光經過具有一定空間周期分布的位相光柵后可形成0級與±1級等高階衍射。利用其中的任意兩束都可以在光柵后表面附近的近場范圍內形成干涉條紋。相位掩模法利用特殊的位相掩模(即相位光柵)結合不同入射角選擇,抑制其中較強且又不需要的衍射束,留下兩個等強度的較強衍射束,可獲得對比度較高的干涉條紋。其主要方法有兩種,一種是激光垂直掩模板方向,此時0級衍射被抑制,±1級衍射相等,其能量可達37%以上;另一種方式是激光以與掩模板法向間夾角θ入射,此時0級透射光束與+1級衍射束光強相等, 通過掩模板的兩束光在菲涅爾近場區發生干涉,產生的干涉條紋周期為掩模板周期的一半。
這種方法所制備的光纖光柵的Bragg波長與光源的波長無關。相位掩模光柵衍射圖樣的周期不依賴于入射光波長,與輻照的角度無關,只與相位光柵的周期Λ有關。對于光纖與掩模之間的校準狀況不敏感,對光路穩定性要求也較低,對輻照光源的瞬間相干性要求也較為放松。總之,相位掩模法工藝穩定、易于準直、重復性好,大大簡化了光纖Bragg光柵制造系統,提高了成柵的效率,提高了光柵的質量。適于大批量生產光纖Bragg光柵。
本實驗是在德國LAMBDA PHYSIK公司生產的COMPex 150T KrF準分子激光器上進行的,該激光器具有高輸出功率(~20W),高脈沖能量(~450mJ),窄線寬(<3pm),發散角小(<0.2mrad)以及高時空相干性等特點。
采用相位掩模法制作折射率周期分布的Bragg光柵的實驗裝置圖如圖3所示。實驗裝置制作部分由準分子激光器、準直系統、柱狀透鏡和振幅掩模板組成。為了進一步提高光的空間相干性,在光纖束后加了準直系統。光束經過準直后,由全反射鏡反射經柱形透鏡聚焦,用來進一步調解曝光能量密度,后通過相位版照射到實驗用的光纖上。
KrF準分子激光器的輸出波長為248nm,光斑的面積為10×
光纖Bragg光柵利用相位掩模板在氫載的普通光纖上制作而成。Bragg中心波長位于1550nm。實驗所用的光纖是普通商用的9μm芯徑的單模通信光纖。為提高其紫外光敏性,實驗前采用載氫增敏的方法[11,12]。在室溫、1.52×104Pa氫氣中處理了約7周。結果表明, 經過這樣長時間的載氫處理,纖芯中的氫溶解度已達到其飽和值,處理后的光纖在96hr內有足夠的光敏性。
轉載請注明出處。








 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀






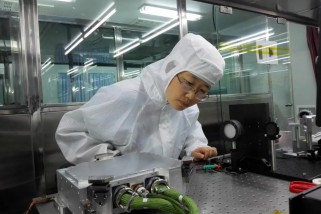

















 關注我們
關注我們




