硅帶切割
該切割方法可提供出色的切割邊緣質(zhì)量,下圖為50W 連續(xù)SPI光纖激光器切割一小塊硅。

圖2 50W 連續(xù)SPI光纖激光器以2.5m/min的速度切割250μm厚的硅帶
化晶圓切割
該激光器在切割化晶圓時(shí),都具備超常的邊緣質(zhì)量,無任何裂痕或碎痕的跡象。這種新型切割工藝,在切割任何形狀時(shí)都能擁有像切割直線那樣的切割質(zhì)量(這個目前是金剛石鋸切割法的缺陷)。
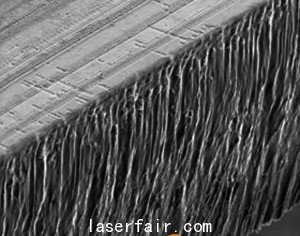
圖3 200W 連續(xù)SPI光纖激光器以3.5m/min的速度切割0.8mm(0.03”)化晶圓
200µm 硅片切割
SPI脈沖激光器也可以用于切割或?qū)柽M(jìn)行劃線。當(dāng)激光運(yùn)行功率為20W,重復(fù)率為65 kHz,脈沖長度 75ns時(shí),可達(dá)到200mm/min的切割速度。這個過程的特征是會在切割邊緣由再次固化反應(yīng)形成的小節(jié)。

圖4 20W,100μm厚硅片,來回切割,等效切割速度250mm/min,
25kHz重復(fù)率,200ns脈沖寬度
使用脈沖激光器,可以很容易地在硅材料上切割盲槽或凹槽。目前SPI正在和一些系統(tǒng)集成商合作,從而將這些切割工藝商業(yè)化。
總結(jié)
硅材料廣泛應(yīng)用于很多工業(yè)領(lǐng)域中,特別是太陽能電池和半導(dǎo)體產(chǎn)業(yè),在珠寶首飾和娛樂產(chǎn)品中的應(yīng)用也在不斷增加。大部分應(yīng)用使用的源材料是以晶片硅的形式存在。通常晶片的厚度為0.2-1.5mm (0.008”–0.06”) ,直徑為100-300mm (4”-12”) 。本文專門集中說明了切割模式晶圓,單晶和多晶硅(200µm)的方法。通過考察脈沖和連續(xù)激光器,發(fā)現(xiàn)光纖激光器相對其他現(xiàn)存的硅切割技術(shù)具有很強(qiáng)的競爭力。
轉(zhuǎn)載請注明出處。







 相關(guān)文章
相關(guān)文章
 熱門資訊
熱門資訊
 精彩導(dǎo)讀
精彩導(dǎo)讀




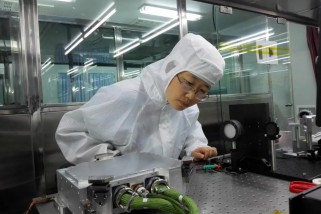






















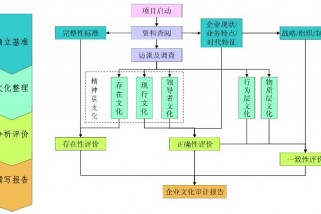





 關(guān)注我們
關(guān)注我們




