傳統(tǒng)的金剛石砂輪高速旋轉(zhuǎn)切割,其表面鑲嵌的凸起的鋒利的鋸齒狀高硬度金剛石顆粒對(duì)切割部位磨削,產(chǎn)生壓力、磨擦力及剪切力將剝離的碎屑帶走,同時(shí)其本身也被磨損,刀片越鈍切割溫度越高即造成劃片刀過(guò)載。由于這些機(jī)械力是直接作用在晶圓表面上并在晶體內(nèi)部產(chǎn)生應(yīng)力和熱損傷,因此易產(chǎn)生正反兩面的崩邊(Chipping)、微損傷、裂痕等問(wèn)題,同時(shí)造成碎屑污染(Silicon dust)。以上問(wèn)題難以通過(guò)其自身工藝的改善完全解決。
隨著器件集成度的增加,芯片尺寸、切割道寬、有源區(qū)到邊緣的距離不斷減小。另外晶片厚度日趨減薄,晶片崩邊、翹曲變形、微粒污染、粗糙度、損傷層、應(yīng)力破壞、易破損、產(chǎn)能下降、碎片率以及刀片損耗等問(wèn)題隨之而來(lái)。實(shí)踐證明磨削加工方式已近接物理極限。
激光加工為非接觸式晶圓切割加工,激光能量通過(guò)光學(xué)聚焦后獲得高能量密度,直接將硅片溶蝕氣化,切割的硅片斷面具有一定粗糙度的表面和最低限度的熱蝕區(qū)。另外,選擇適合的激光波長(zhǎng)和頻率,激光能被硅材料有效地吸收,因此其可在很窄的寬度區(qū)域進(jìn)行精細(xì)微加工,達(dá)到對(duì)材料分子鍵級(jí)的斷裂破壞。
用激光對(duì)晶圓進(jìn)行精密劃片切割是對(duì)易碎的單晶硅晶圓砂輪刀片機(jī)械劃片裂片的最佳替代工藝。激光可對(duì)所有第III-V主族材料包括第IV主族材料如硅(Si)和鍺(Ge)的晶圓進(jìn)行快速劃片切割。硅晶圓片,切口寬度均小于25微米,切口邊緣平直、精確,沒(méi)有裂紋、位錯(cuò)、 崩裂,尤其對(duì)選擇參考解理面的硅晶圓更是如此。采用激光劃片工藝使得成品率更高,并因?yàn)閾p壞的芯片非常少而獲得更高的成品率。在半導(dǎo)體性?xún)r(jià)比的需求驅(qū)動(dòng)下,芯片成本不斷降低,尺寸越來(lái)越小。切割寬度從100微米降到30微米,采用激光劃片工藝后,劃片槽寬度進(jìn)一步降低到20微米。激光劃片工藝能夠提高產(chǎn)能。目前,激光劃片速度能夠達(dá)到200mm/s以上。相對(duì)于機(jī)械式劃片工藝,激光工藝具有更多優(yōu)點(diǎn)。這些優(yōu)點(diǎn)包括消耗成本低、維護(hù)費(fèi)用少、產(chǎn)能高、晶圓面積利用率高等。激光工藝更易于進(jìn)行自動(dòng)化操作,從而降低人力成本。
激光技術(shù)還有很大技術(shù)潛能,激光切割以其顯著的非接觸、無(wú)應(yīng)力、低損傷、靈活性、速度快等優(yōu)勢(shì)著稱(chēng)。半導(dǎo)體晶片切割應(yīng)用,激光是一條必由之路。金剛石砂輪切割已經(jīng)完成其歷史使命。新一代的晶片切割和微加工勢(shì)必采用更新的工藝方法。
轉(zhuǎn)載請(qǐng)注明出處。









 相關(guān)文章
相關(guān)文章
 熱門(mén)資訊
熱門(mén)資訊
 精彩導(dǎo)讀
精彩導(dǎo)讀







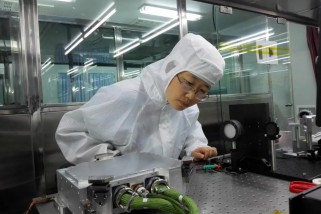
















 關(guān)注我們
關(guān)注我們




