近日,由中科院上海光機所牽頭,上海理工大學、國家光刻設備工程技術研究中心共同承擔的上海市基礎研究重點項目“光刻成像焦深延拓與像質原位檢測的理論和實驗研究”通過上海市科委驗收。
極大規模集成電路已成為幾乎一切高技術領域發展的基礎。新一代集成電路的出現,總是以光刻工藝實現更小的芯片特征尺寸為主要技術標志。根據2009年國際 半導體技術藍圖,193納米浸沒式光刻技術是45納米以下節點重要的光刻技術,經過技術創新可延伸至16納米節點。在超大數值孔徑投影物鏡與偏振光照明條 件下,如何通過理論創新和突破,發展適用于上述節點的193納米浸沒式光刻機的像質原位檢測技術與焦深延拓技術是該領域面臨的一個重要研究課題。
上海光機所王向朝研究員研究團隊、上海理工大學莊松林院士研究團隊與國家光刻設備工程技術研究中心密切合作,在光刻機像質原位檢測技術與光刻成像焦深延拓 技術研究領域取得了重大進展。在大視場、大數值孔徑投影物鏡與偏振光照明條件下,基于掩模電磁場三維散射理論與物方衍射的偏振和非近軸特性,建立了描述光 刻系統像空間光場分布的矢量場衍射理論與光刻矢量場成像理論模型;基于Hopkins部分相干成像理論和非近軸標量場成像條件,通過引入傾斜因子分別從振 幅和相位兩方面對國際現有光刻成像理論進行了修正,完善了標量場光刻成像理論模型;基于電磁波矢量平面波譜理論建立了應用于共軸光學系統和雙折射光學系統 的光學矢量場成像理論模型,發展了矢量場衍射的焦深延拓理論模型。在此基礎上,該項目建立了投影物鏡波像差檢測線性模型,研究了能夠較大幅度提高測量精度 的投影物鏡波像差檢測新技術,研究了浸沒式光刻機偏振照明優化技術,分析了特殊偏振光產生與轉換調節新方法。項目相關研究成果已在上海微電子裝備有限公司 研發的步進掃描投影光刻機上得到應用。
在項目研究過程中,項目組建立了光學成像系統聚焦區三維光強分布納米級分辨率測量平臺與光刻機像質原位檢測技術基礎研究實驗平臺。項目組在國際一流光學期 刊《Optics Express》、《Applied Optics》、《Journal of Optics Society of America A》、國際一流微電子期刊《Microelectronic Engineering》等學術刊物上發表SCI收錄論文20篇,申請國家專利31項,其中發明專利27項。
轉載請注明出處。









 相關文章
相關文章
 熱門資訊
熱門資訊
 精彩導讀
精彩導讀







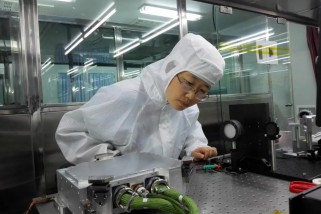
















 關注我們
關注我們




